Advanced Semiconductor Packaging
Advanced Semiconductor Packaging
At i3 Microsystems we integrate advanced process and product development with manufacturing to provide wafer level, flip chip and wire bond packaging assemblies from prototype to volume production.
i3 has earned global respect as assembly process experts, enabling customers to increase yields, continually improve processes, and optimize product reliability using our material science and engineering expertise.
Our solutions support the needs of the defense and aerospace, IT, server and super computing and medical markets where highly reliable products built in robust manufacturing operations are essential to success.
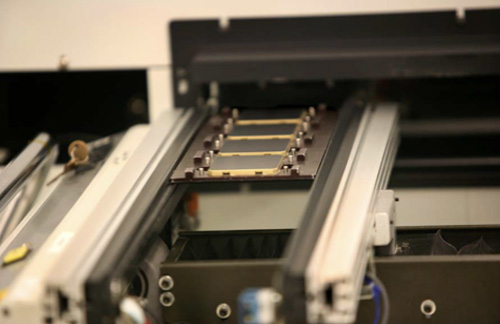
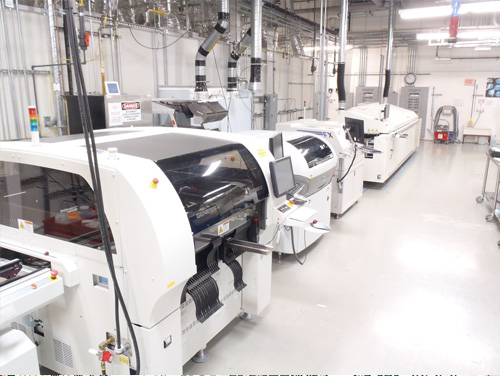
- Standard JEDEC 13.0 mm to 55.0 mm
- Custom-Sized SiP’s
- FR4
- FR4 Epoxy Build-Up
- PFTE-Based Carriers
- Kapton Flex
- Flip chip to 125 μm pitch and >25.0 mm die
- Heatspreader attach with mixed adhesives
- Wirebond dam and glob top
- Underfill for die and connectors
- Pin arrays and BGA attach
- Wirebond-die up and cavity
- Ball bonding
- Pb free die bumps
- Die attach
- Die place reflow
- Post attach automated optical inspection
- BGA attach
- Wirebonding
- Discrete component connector attach
- Underfill for die and connectors
- Wirebond damming and glob top
- Coverplate attachment
Wire Bond Assembly | |
|---|---|
Ultra Fine Pitch | 35 μm inline bond pad pitch |
Wire size | 0.6 mil to 2.5 mil copper, silver, or gold wire |
Bonding Area | X axis: 56 mm |
Y Axis: 80 mm (Standard) | |
Total Bond Placement Accuracy | 2.0 μm @ 3 sigma |
Vertical Wire Pull Capabilities | |
Wire Sway | Wire length < 2.54 mm: 25 μm @ 3 sigma |
Wire length < 2.54 mm: 1% wire length @ 3 sigma | |
Height of the vertical wires | Minimum of .25mm and a maximum of 1.3mm |
Wire bond height | 1.300 / 1.260 mm (+20 μm) |
The XY location accuracy of the "free end" of each vertical wire | Repeatable to +/-10μm |
The "Z" height of the wire | Repeatable to +/-20μm |


System-in-Package and Shrink
Reducing system size, weight, and power (SWaP) is critical to the development of new applications, especially for the defense industry. By achieving reductions in the form factor and power consumption of today’s military and medical electronics, i3 is able to improve mobility and extend operational life, enhancing the overall viability of the product in the marketplace.
Our innovative System-in-Package technology is perfect for the following markets:
- Aerospace & Defense
- High Performance Computing
- Medical
- Industrial
i3 has developed system-in-package technology to achieve SWaP goals, bring differentiated products to market quickly and efficiently, and to establish design and supply chain continuity.
Product transferred to Production
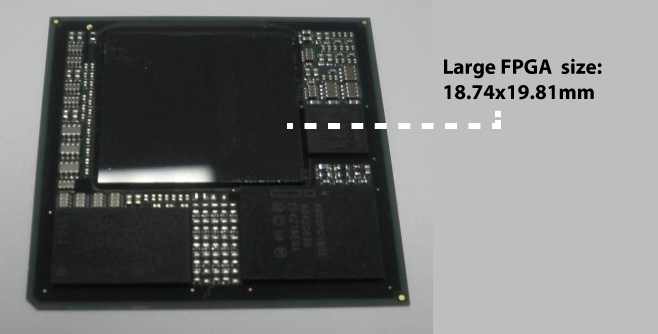
- Package Size: 45 x 45mm, 683μm thick
- Substrate: PTFE
- X-section 9 layer
- 50μm vias, 30/35μm Line/space
- 5348 Flip Chip bumps
- 728 BGA I/O
- 1 very large standard solder Xilinx Flip Chip FPGA
- 1 RAM
- 1 Flash Memory
- 1 Programmable Logic Device with user flash
- 123 Discrete components placed: 0402 minimum size
- Mixed standard solder die attach with lead free SMT components
- Functional final test with thermal cycling
Benefits of Utilizing i3’s SiP Technology
- Enable more functionality in smaller packages with our organic substrates
- Improve electrical performance through a reduction in trace lengths
- Simplify, and in many cases eliminate, complex PCB’s all together
- Prepackaged IC’s, surface mount components, memory, passives and connectors, while increasing reliability and decreasing weight
- Improve electrical performance, address thermal considerations, provide miniaturization, minimize complexity and achieve size reductions up to 27x or greater
Original PCB Size: 108 in2 ⇨ Final Sip size: 4 in2
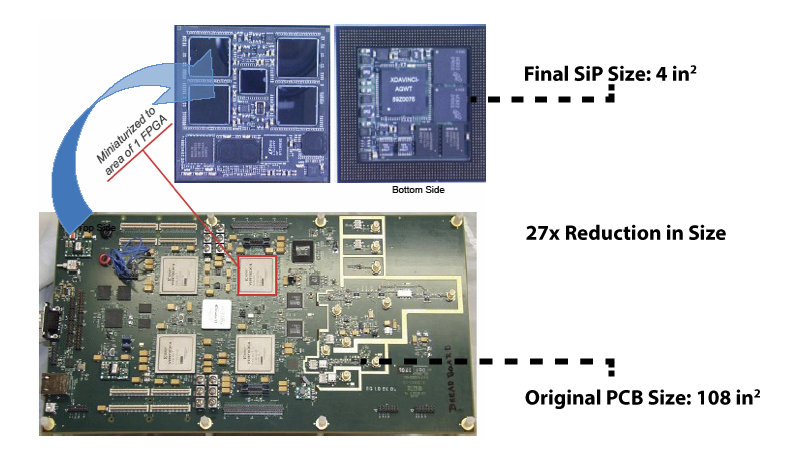
- Package Size: 55 x 55mm, 683μm thick
- Substrate: Particle filled epoxy
- X-section 3-4-3
- 50μm vias, 30/35μm Line/space
- 84 ft HDI wiring
- >39,000 40 micron UV laser drilled vias
- 5 Flip Chip FPGA
- 4 Xilinx FPGA, 3264 I/O w/190μm minimum pitch
- Discrete components: 0201 minimum size
- 638 SMT components placed
- Functional final socket & Bed of Nails topside test
- Custom Peripheral Pin connector & Lid
